Реферат на тему:
Полевой транзистор — полупроводниковый прибор, в котором ток изменяется в результате действия перпендикулярного току электрического поля, создаваемого входным сигналом.
Протекание в полевом транзисторе рабочего тока обусловлено носителями заряда только одного знака (электронами или дырками), поэтому такие приборы часто включают в более широкий класс униполярных электронных приборов (в отличие от биполярных).
Идея полевого транзистора с изолированным затвором была предложена Лилиенфельдом в 1926—1928 годах. Однако объективные трудности в реализации этой конструкции позволили создать первый работающий прибор этого типа только в 1960 году. В 1953 году Дейки и Росс предложили и реализовали другую конструкцию полевого транзистора — с управляющим p-n-переходом. Наконец, третья конструкция полевых транзисторов — полевых транзисторов с барьером Шоттки — была предложена и реализована Мидом в 1966 году.
Полевой транзистор можно включать по одной из трех основных схем: с общим истоком (ОИ), общим стоком (ОС) и общим затвором (ОЗ).
На практике чаще всего применяется схема с ОИ, аналогичная схеме на биполярном транзисторе с ОЭ. Каскад с общим истоком даёт очень большое усиление тока и мощности. Схема с ОЗ аналогична схеме с ОБ. Она не даёт усиления тока, и поэтому усиление мощности в ней во много раз меньше, чем в схеме ОИ. Каскад ОЗ обладает низким входным сопротивлением, в связи с чем он имеет ограниченное практическое применение в усилительной технике.
По физической структуре и механизму работы полевые транзисторы условно делят на 2 группы. Первую образуют транзисторы с управляющим р-n переходом или переходом металл — полупроводник (барьер Шоттки), вторую — транзисторы с управлением посредством изолированного электрода (затвора), т. н. транзисторы МДП (металл — диэлектрик — полупроводник).
Рис. 1. Устройство полевого транзистора с управляющим p-n переходом
Полевой транзистор с управляющим p-n переходом — это полевой транзистор, затвор которого изолирован (то есть отделён в электрическом отношении) от канала p-n переходом, смещённым в обратном направлении.
Такой транзистор имеет два невыпрямляющих контакта к области, по которой проходит управляемый ток основных носителей заряда, и один или два управляющих электронно-дырочных перехода, смещённых в обратном направлении (см. рис. 1). При изменении обратного напряжения на p-n переходе изменяется его толщина и, следовательно, толщина области, по которой проходит управляемый ток основных носителей заряда. Область, толщина и поперечное сечение которой управляется внешним напряжением на управляющем p-n переходе и по которой проходит управляемый ток основных носителей, называют каналом. Электрод, из которого в канал входят основные носители заряда, называют истоком. Электрод, через который из канала уходят основные носители заряда, называют стоком. Электрод, служащий для регулирования поперечного сечения канала, называют затвором.
Электропроводность канала может быть как n-, так и p-типа. Поэтому по электропроводности канала различают полевые транзисторы с n-каналом и р-каналом. Все полярности напряжений смещения, подаваемых на электроды транзисторов с n- и с p-каналом, противоположны.
Управление током стока, то есть током от внешнего относительно мощного источника питания в цепи нагрузки, происходит при изменении обратного напряжения на p-n переходе затвора (или на двух p-n переходах одновременно). В связи с малостью обратных токов мощность, необходимая для управления током стока и потребляемая от источника сигнала в цепи затвора, оказывается ничтожно малой. Поэтому полевой транзистор может обеспечить усиление электромагнитных колебании как по мощности, так и по току и напряжению.
Таким образом, полевой транзистор по принципу действия аналогичен вакуумному триоду. Исток в полевом транзисторе подобен катоду вакуумного триода, затвор — сетке, сток — аноду. Но при этом полевой транзистор существенно отличается от вакуумного триода. Во-первых, для работы полевого транзистора не требуется подогрева катода. Во-вторых, любую из функций истока и стока может выполнять каждый из этих электродов. В-третьих, полевые транзисторы могут быть сделаны как с n-каналом, так и с p-каналом, что позволяет удачно сочетать эти два типа полевых транзисторов в схемах.
От биполярного транзистора полевой транзистор отличается, во-первых, принципом действия: в биполярном транзисторе управление выходным сигналом производится входным током, а в полевом транзисторе — входным напряжением или электрическим полем. Во-вторых, полевые транзисторы имеют значительно большие входные сопротивления, что связано с обратным смещением p-n-перехода затвора в рассматриваемом типе полевых транзисторов. В-третьих, полевые транзисторы могут обладать низким уровнем шума (особенно на низких частотах), так как в полевых транзисторах не используется явление инжекции неосновных носителей заряда и канал полевого транзистора может быть отделён от поверхности полупроводникового кристалла. Процессы рекомбинации носителей в p-n переходе и в базе биполярного транзистора, а также генерационно-рекомбинационные процессы на поверхности кристалла полупроводника сопровождаются возникновением низкочастотных шумов.
Рис. 2. Устройство полевого транзистора с изолированным затвором.
Полевой транзистор с изолированным затвором — это полевой транзистор, затвор которого отделён в электрическом отношении от канала слоем диэлектрика.
В кристалле полупроводника с относительно высоким удельным сопротивлением, который называют подложкой, созданы две сильнолегированные области с противоположным относительно подложки типом проводимости. На эти области нанесены металлические электроды — исток и сток. Расстояние между сильно легированными областями истока и стока может быть меньше микрона. Поверхность кристалла полупроводника между истоком и стоком покрыта тонким слоем (порядка 0,1 мкм) диэлектрика. Так как исходным полупроводником для полевых транзисторов обычно является кремний, то в качестве диэлектрика используется слой двуокиси кремния SiO2, выращенный на поверхности кристалла кремния путём высокотемпературного окисления. На слой диэлектрика нанесён металлический электрод — затвор. Получается структура, состоящая из металла, диэлектрика и полупроводника. Поэтому полевые транзисторы с изолированным затвором часто называют МДП-транзисторами.
Входное сопротивление МДП-транзисторов может достигать 1010…1014 Ом (у полевых транзисторов с управляющим p-n-переходом 107…109), что является преимуществом при построении высокоточных устройств.
Существуют две разновидности МДП-транзисторов: с индуцированным каналом и со встроенным каналом.
В МДП-транзисторах с индуцированным каналом (рис. 2, а) проводящий канал между сильнолегированными областями истока и стока отсутствует и, следовательно, заметный ток стока появляется только при определённой полярности и при определённом значении напряжения на затворе относительно истока, которое называют пороговым напряжением (UЗИпор).
В МДП-транзисторах со встроенным каналом (рис. 2, б) у поверхности полупроводника под затвором при нулевом напряжении на затворе относительно истока существует инверсный слой — канал, который соединяет исток со стоком.
Изображённые на рис. 2 структуры полевых транзисторов с изолированным затвором имеют подложку с электропроводностью n-типа. Поэтому сильнолегированные области под истоком и стоком, а также индуцированный и встроенный канал имеют электропроводность p-типа. Если же аналогичные транзисторы созданы на подложке с электропроводностью p-типа, то канал у них будет иметь электропроводность n-типа.
При напряжении на затворе относительно истока, равном нулю, и при наличии напряжения на стоке, — ток стока оказывается ничтожно малым. Он представляет собой обратный ток p-n перехода между подложкой и сильнолегированной областью стока. При отрицательном потенциале на затворе (для структуры, показанной на рис. 2, а) в результате проникновения электрического поля через диэлектрический слой в полупроводник при малых напряжениях на затворе (меньших UЗИпор) у поверхности полупроводника под затвором возникает обеднённый основными носителями слой эффект поля и область объёмного заряда, состоящая из ионизированных нескомпенсированных примесных атомов. При напряжениях на затворе, больших UЗИпор, у поверхности полупроводника под затвором возникает инверсный слой, который и является каналом, соединяющим исток со стоком. Толщина и поперечное сечение канала будут изменяться с изменением напряжения на затворе, соответственно будет изменяться и ток стока, то есть ток в цепи нагрузки и относительно мощного источника питания. Так происходит управление током стока в полевом транзисторе с изолированным затвором и с индуцированным каналом.
В связи с тем, что затвор отделён от подложки диэлектрическим слоем, ток в цепи затвора ничтожно мал, мала и мощность, потребляемая от источника сигнала в цепи затвора и необходимая для управления относительно большим током стока. Таким образом, МДП-транзистор с индуцированным каналом может производить усиление электромагнитных колебаний по напряжению и по мощности.
Принцип усиления мощности в МДП-транзисторах можно рассматривать с точки зрения передачи носителями заряда энергии постоянного электрического поля (энергии источника питания в выходной цепи) переменному электрическому полю. В МДП-транзисторе до возникновения канала почти всё напряжение источника питания в цепи стока падало на полупроводнике между истоком и стоком, создавая относительно большую постоянную составляющую напряжённости электрического поля. Под действием напряжения на затворе в полупроводнике под затвором возникает канал, по которому от истока к стоку движутся носители заряда — дырки. Дырки, двигаясь по направлению постоянной составляющей электрического поля, разгоняются этим полем и их энергия увеличивается за счёт энергии источника питания, в цепи стока. Одновременно с возникновением канала и появлением в нём подвижных носителей заряда уменьшается напряжение на стоке, то есть мгновенное значение переменной составляющей электрического поля в канале направлено противоположно постоянной составляющей. Поэтому дырки тормозятся переменным электрическим полем, отдавая ему часть своей энергии.
Рис. 3. Выходные статические характеристики (a) и статические характеристики передачи (b) МДП-транзистора со встроенным каналом.
В данной схеме в качестве нелинейного элемента используется МДП транзистор с изолированным затвором и индуцированным каналом.
В связи с наличием встроенного канала в таком МДП-транзисторе при нулевом напряжении на затворе (см. рис. 2, б) поперечное сечение и проводимость канала будут изменяться при изменении напряжения на затворе как отрицательной, так и положительной полярности. Таким образом, МДП-транзистор со встроенным каналом может работать в двух режимах: в режиме обогащения и в режиме обеднения канала носителями заряда. Эта особенность МДП-транзисторов со встроенным каналом отражается и на смещении выходных статических характеристик при изменении напряжения на затворе и его полярности (рис. 3).
Статические характеристики передачи (рис. 3, b) выходят из точки на оси абсцисс, соответствующей напряжению отсечки UЗИотс, то есть напряжению между затвором и истоком МДП-транзистора со встроенным каналом, работающего в режиме обеднения, при котором ток стока достигает заданного низкого значения.
Формулы расчёта в зависимости от напряжения UЗИ
1. Транзистор закрыт
Пороговое значение напряжения МДП транзистора
2. Параболический участок.
-удельная крутизна транзистора.
3. Дальнейшее увеличение U3u приводит к переходу на пологий уровень.
В структурах типа металл-нитрид-оксид-полупроводник (МНОП) диэлектрик под затвором выполняется двухслойным: слой оксида SiO2 и толстый слой нитрида Si3N4. Между слоями образуются ловушки электронов, которые при подаче на затвор МНОП-структуры положительного напряжения (28..30 В) захватывают туннелирующие через тонкий слой SiO2 электроны. Образующиеся отрицательно заряженные ионы повышают пороговое напряжение, причём их заряд может храниться до нескольких лет при отсутствии питания, так как слой SiO2 предотвращает утечку заряда. При подаче на затвор большого отрицательного напряжения (28…30 В), накопленный заряд рассасывается, что существенно уменьшает пороговое напряжение.
Структуры типа металл-оксид-полупроводник (МОП) с плавающим затвором и лавинной инжекцией (ЛИЗМОП) имеют затвор, выполненный из поликристаллического кремния, изолированный от других частей структуры. Лавинный пробой p-n-перехода подложки и стока или истока, на которые подаётся высокое напряжение, позволяет электронам проникнуть через слой окисла на затвор, вследствие чего на нём появляется отрицательный заряд. Изолирующие свойства диэлектрика позволяют сохранять это заряд десятки лет. Удаление электрического заряда с затвора осуществляется с помощью ионизирующего ультрафиолетового облучения кварцевыми лампами, при этом фототок позволяет электронам рекомбинировать с дырками.
В дальнейшем были разработаны структуры запоминающих полевых транзисторов с двойным затвором. Встроенный в диэлектрик затвор используется для хранения заряда, определяющего состояние прибора, а внешний (обычный) затвор, управляемый разнополярными импульсами для ввода или удаления заряда на встроенном (внутреннем) затворе. Так появились ячейки, а затем и микросхемы флэш-памяти, получившие в наши дни большую популярность и составившие заметную конкуренцию жестким дискам в компьютерах.
Для реализации сверхбольших интегральных схем (СБИС) были созданы сверхминиатюрные полевые микротранзисторы. Они делаются с применением нанотехнологий с геометрическим разрешением менее 100 нм. У таких приборов толщина подзатворного диэлектрика доходит до нескольких атомных слоев. Используются различные, в том числе трехзатворные структуры. Приборы работают в микромощном режиме. В современных микропроцессорах корпорации Intel число приборов составляет от десятков миллионов до 2 миллиардов. Новейшие полевые микротранзисторы выполняются на напряженном кремнии, имеют металлический затвор и используют новый запатентованный материал для подзатворного диэлектрика на основе соединений гафния.[1]
В последние четверть века бурное развитие получили мощные полевые транзисторы, в основном МДП-типа. Они состоят из множества маломощных структур или из структур с разветвлённой конфигурацией затвора. Такие ВЧ и СВЧ приборы впервые были созданы в СССР специалистами НИИ «Пульсар» Бачуриным В. В. (кремниевые приборы) и Ваксембургом В. Я. (арсенид-галлиевые приборы) Исследование их импульсных свойств было выполнено научной школой проф. Дьяконова В. П. (Смоленский филиал МЭИ). Это открыло область разработки мощных ключевых (импульсных) полевых транзисторов со специальными структурами, имеющих высокие рабочие напряжения и токи (раздельно до 500—1000 В и 50-100 А). Такие приборы нередко управляются малыми (до 5 В) напряжениями, имеют малое сопротивление в открытом состоянии (до 0,01 Ом) у сильноточных приборов, высокую крутизну и малые (в единицы-десятки нс) времена переключения. У них отсутствует явление накопления носителей в структуре и явление насыщения, присушее биполярным транзисторам. Благодаря этому мощные полевые транзисторы успешно вытесняют мощные биполярные транзисторы в области силовой электроники малой и средней мощности.[2][3]
За рубежом в последние десятилетия стремительно развивается технология транзисторов на высокоподвижных электронах (ТВПЭ), которые широко используются в СВЧ устройствах связи и радионаблюдения. На основе ТВПЭ создаются как гибридные, так и монолитные микроволновые интегральные схемы (англ.)). В основе действия ТВПЭ лежит управление каналом с помощью двумерного электронного газа, область которого создаётся под контактом затвора благодаря применению гетероперехода и очень тонкого диэлектрического слоя — спейсера.[4]
Значительная часть производимых в настоящий момент полевых транзисторов входит в состав КМОП-структур, которые строятся из полевых транзисторов с каналами разного (p- и n-) типа проводимости и широко используются в цифровых и аналоговых интегральных схемах.
За счёт того, что полевые транзисторы управляются полем (величиной напряжения приложенного к затвору), а не током, протекающим через базу (как в биполярных транзисторах), полевые транзисторы потребляют значительно меньше энергии, что особенно актуально в схемах ждущих и следящих устройств, а также в схемах малого потребления и энергосбережения (реализация спящих режимов).
Выдающиеся примеры устройств, построенных на полевых транзисторах, — наручные кварцевые часы и пульт дистанционного управления для телевизора. За счёт применения КМОП-структур эти устройства могут работать до нескольких лет, потому что практически не потребляют энергии.
Грандиозными темпами развиваются области применения мощных полевых транзисторов. Их применение в радиопередающих устройствах позволяет получить повышенную чистоту спектра излучаемых радиосигналов, уменьшить уровень помех и повысить надёжность радиопередатчиков. В силовой электронике ключевые мощные полевые транзисторы успешно заменяют и вытесняют мощные биполярные транзисторы. В силовых преобразователях они позволяют на 1-2 порядка повысить частоту преобразования и резко уменьшить габариты и массу энергетических преобразователей. В устройствах большой мощности используются биполярные транзисторы с полевым управлением (IGBT) успешно вытесняющие тиристоры. В усилителях мощности звуковых частот высшего класса HiFi и HiEnd мощные полевые транзисторы успешно заменяют мощные электронные лампы, обладающие малыми нелинейными и динамическими искажениями.
wreferat.baza-referat.ru
В отличие от биполярных, полевые транзисторы (ПТ) основаны на дрейфе основных носителей тока в канале под действием разности потенциалов между истоковым и стоковым зажимами. Ток канала можно модулировать, изменяя напряжение затвора относительно истока. В зависимости от конструкции затвора ПТ делятся на два класса: с затвором в виде р-n-перехода (ПТ с управляющим переходом) и с изолированным затвором. Последние относительно затвора представляют собой структуру: металл-диэлектрик-полупроводник и поэтому называются либо МДП (MOS в английской транскрипции) транзисторами, либо МОП-транзисторами (МОП — аббревиатура от «металл-окисел-полупроводник»). Для этих приборов также широко применяется название MOSFET (Metal-Oxid-Semiconductor-Field-Effect Transistor), подчеркивающее, что управление каналом осуществляется электрическим полем. Оба класса ПТ широко распространены в силовой электронике и имеют «свои» предпочтительные области применения. МДП-транзисторы в свою очередь подразделяются на транзисторы со встроенным каналом и с индуцированным каналом. В первых ПТ проводящий токовый канал создан технологически («встроен»), и он, как и в ПТ с управляющим переходом, существует при нулевом напряжении на затворе, поэтому эти МДП транзисторы называют транзисторами обедненного типа. В МДП с индуцированным каналом токовый канал появляется только при подачи напряжения на затвор, поэтому эти приборы также называют транзисторами обогащенного типа. МДП обогащенного типа могут быть, как и любые другие ПТ, с каналом n-типа и с каналом p-типа, которые чаще всего создаются методом диффузии. Функционально эти два типа МДП-транзисторов являются аналогами n-р-n- и р-n-р-биполярных транзисторов соответственно. В современных устройствах электропитания наибольшее применение в качестве мощных токовых, ключей находят МДП-транзисторы с индуцированным n-каналом (DNMOS в английской транскрипции). В этих приборах для создания токового канала между стоком и истоком на затвор необходимо подать положительное напряжение относительно истока, большее некоторого порогового, т. е. приборы являются нормально закрытыми. Далее обсуждаются именно эти приборы.
К достоинствам ПТ следует отнести:
• чрезвычайно малую мощность управления по сравнению биполярными транзисторами;
• высокую скорость переключения, резко снижающую коммутационные (динамические) потери мощности;
• возможность параллельного включения между собой транзисторов, без каких либо устройств выравнивания токов через эти транзисторы;
• высокая температурная стабильность времени переключения и крутизны вольтамперной характеристики.
Из недостатков ПТ можно отметить возможность вторичного пробоя, вызванного влиянием паразитного биполярного n-р-n-транзистора, образующегося в полупроводниковой структуре. При низких напряжениях сток-исток паразитный транзистор не проявляет себя. С повышением напряжения биполярный транзистор «просыпается», определяя вид ВАХ транзистора в области пробоя. Для того чтобы обеспечить нормальную работу МДП-транзисторов в области рабочих напряжений, необходимо надежно закрыть этот паразитный транзистор. Для этого подложка прибора всегда соединяется с истоковым выводом, в результате чего база и эмиттер этого паразитного транзистора оказываются практически объединены между собой, и этот транзистор превращается в диод, включенный между стоковым и истоковым выводами. В настоящее время выпускаются МДП-транзисторы с рабочим напряжением сток-исток 800... 1000 В.
Рассмотрим типичные статические характеристики МДП-транзистора. На проходной характеристике показаны две кривые для двух различных напряжений Uси (Uси2 >Uси1)
На проходной характеристике отмечено пороговое напряжение Uпор, при котором начинает открываться транзистор. Конструктивно-технологическими способами удается получить режим образования канала и открывания транзистора при напряжении Uпор выше 2...4 В. Следует отметить, что из-за малости толщины подзатворного изоляционного слоя предельное значение напряжения между затвором и истоком не должно превышать 20 В. Его превышение вызывает электрический пробой изоляции затвора и выход из строя прибора.

Для защиты транзистора в его входной цепи рекомендуется включение ограничивающего стабилитрона с напряжением стабилизации Uстаб <20 В. В отдельных приборах такой стабилитрон встроен в структуру транзистора. По проходной характеристики определяется крутизна S = dic/duзи. В современных мощных транзисторах крутизна характеристики достигает значений 2,5...4 А/В. На выходных характеристиках выделяются два участка, разделяемых значением напряжения насыщения Uс нас (границей режимов). Наклон крутых участков выходных характеристик определяет сопротивление Rси = ΔUси/AIс канала сток-исток в режиме насыщения. Для современных мощных транзисторов Rси составляет десятые-сотые доли ома.
Для лучшего представления о переключающих свойствах МОП-транзисторов рассмотрим его работу в режиме переключения при активной нагрузке в цепи стока.На схеме показаны паразитные емкости транзистора: затвор-исток Сзи, сток-исток Сси и сток-затвор Сзс. Паразитные емкости транзистора, как и резистивные элементы, сильно зависят от конструктивного исполнения транзисторов. Учитывая, что мощный прибор может содержать тысячи элементарных транзисторов на одном кристалле, соединенных параллельно, результирующие емкости могут достигать больших значений (например, для транзистора КП803 Сзи = 3000 пФ). Особенностью проходной емкости Сзс, называемой также емкостью Миллера, является ее зависимость от напряжения на стоке. Наличие диода приводит к образованию тока в третьем квадранте семейства выходных характеристик. Это свойство МОП-транзистора используется в схемах, содержащих индуктивные накопители тока для создания режимов рекуперации энергии. Быстродействие этого диода, определяемое временем восстановления его запирающих свойств, относительно не велико (tв = 100...300 нс), что создает определенные трудности при высокой частоте переключения индуктивных нагрузок транзисторной стойкой в полумостовых и мостовых схемах.
В первом приближении управление транзистором сводится к соответствующему изменению заряда входной емкости Свх = Сзи + Сзс транзистора. При этом существенное влияние оказывает внутреннее сопротивление Rг источника управляющих импульсов, препятствующее быстрому заряду и разряду емкости Свх.
При подачи в момент времени t1 на вход (затвор-исток) управляющего импульса Uвх начинается заряд емкостей Сзи и Сзс через резистор Rr. До тех пор пока напряжение затвор-исток не достигнет величины порогового напряжения Unop, транзистор закрыт и напряжение стока равно напряжению питания Еп. Понятно, что для повышения быстродействия транзистора на этой стадии процесса переключения необходимо уменьшать сопротивление Rг. Однако следует иметь в виду, что чрезмерно большая скорость заряда емкости Сзи может привести к неравномерному распределению напряжения Uзи по площади затвора и, как следствие, привести к кумуляции тока стока на отдельных участках сечения индуцированного канала.
После достижения в момент времени t2 на затворе порогового напряжения транзистор открывается и переходит в линейный режим, нарастает ток стока, падает напряжение, на стоке Uси. На интервале [t1, t3] емкость Миллера Сзс мала.
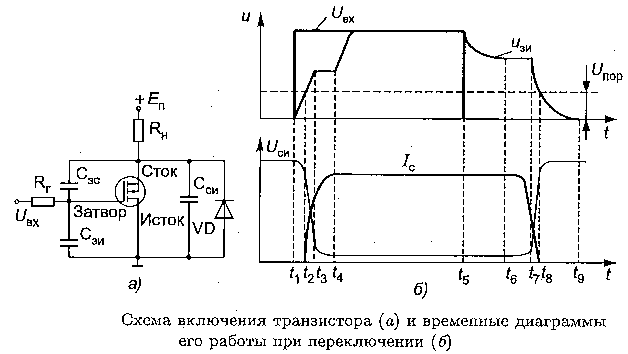
В момент времени t3 величина Сзс начинает резко возрастать, что объясняет появление «полки» на кривой uзи(t) на интервале [t3, t4] (это явление называют интегрированием Миллера). После момента времени продолжается рост напряжения uзи с некоторым сниженим скорости падения напряжения uси. Затем транзистор окончательно переходит в режим насыщения.
В момент времени t5 управляющий импульс принимает нулевое значение и начинается процесс выключения транзистора. Однако на интервале времени [t5, t6] из-за заряженной емкости Свх транзистор по-прежнему находится в режиме насыщения и полностью выключается лишь после снижения uзи ниже порогового напряжения в момент t9. На интервале времени [t5, t9] входная емкость разряжается через сопротивление Rr с постоянной времени tpaз р = Gвх Rг. На интервале [t6, t7]вновь проявляется интегратор Миллера, вызванный снижением величины Сзс.
Механизм переключения МОП-транзистора характеризуется наличием интервалов задержки при включении ([t2, t1]) и выключении ([t6, t5]), длительность которых пропорциональна постоянной времени RrGвх. Определяющее влияние на длительность включения ([t4, t2]) и выключения ([t8, t6]) оказывает емкость Сзс, существенно меньшее влияние — емкости Сзи и Сси. Этот механизм переключения хорошо подтверждается экспериментальными кривыми, приведенными, например, в.
Динамические потери мощности в МОП-транзисторе при правильном режиме управления пренебрежимо малы до частоты переключения порядка 50...100 кГц, а общие потери определяются статической составляющей, т.е. падением напряжения на сопротивлении Rси открытого транзистора.
При активно-индуктивной нагрузке в цепи стока характер процессов на этапе включения транзистора существенно изменяется.

Для снижения перенапряжения на стоке при выключении транзистора нагрузка обычно шунтируется вспомогательным диодом VD. Будем считать, что на интервале переключения (интервал [t2, t5]) ток нагрузки остается неизменным и равным его значению в момент времени t2 (Iн2). Как и при активной нагрузке, ток стока нарастает, начиная с момента времени t2, когда напряжение на затворе Uзи достигает значения порога открывания Uпор. Далее начинается этап выключения диода VD. Ток стока нарастает через открытый диод. Скорость роста iс определяется скоростью заряда входной емкости и паразитными индуктивностями контура «источник, диод, транзистор, источник». К моменту времени t3 ток стока достигает значения Iн2 (ток диода уменьшается до нуля), однако из-за задержки выключения диода ток стока продолжает расти до максимального значения Iст > Iн2. В момент времени t4 начинается восстановление запирающих свойств диода (его обратный ток стремится к нулю), соответственно и ток стока уменьшается до значения Iн2. Начиная с момента времени t4, напряжение на стоке начинает снижаться. С этого момента также начинает проявляться эффект Миллера, сопровождаемый образованием «полки» на кривой uзи(t).
Таким образом, наличие вспомогательного диода VD приводит к опасности возникновения импульсов потерь мощности на транзисторе с пиком А Рс вблизи момента времени t4. Для повышения надежности работы ключа необходимо уменьшать пиковые значения потерь мощности, что требует применения быстродействующих диодов.
Используемая литература: Электропитание устройств и систем телекоммуникаций: Учебное пособие для вузов / В. М. Бушуев, В. А. Демянский, Л. Ф. Захаров и др. — М.: Горячая линия—Телеком, 2009. — 384 с.: ил.
Скачать реферат: У вас нет доступа к скачиванию файлов с нашего сервера. КАК ТУТ СКАЧИВАТЬ
Пароль на архив: privetstudent.com
privetstudent.com
В последние годы большое место в электронике заняли приборы,
использующие явления в приповерхностном слое полупроводника. Основным
элементом таких приборов является структура
Металл-Диэллектрик-Полупроводник /МДП/. В качестве диэллектрической
прослойки между металлом и полупроводником часто используют слой
оксида, например диоксид кремния. Такие структуры носят название
МОП-структур. Металлический электрод обычно наносят на диэллектрик
вакуумным распылением. Этот электрод называется затвором.
Если на затвор подать некоторое напряжение смещения относительно
полупроводника, то у поверхности полупроводника возникает область
объемного заряда, знак которой противоположен знаку заряда на затворе.
В этой области концентрация носителей тока может существенно
отличаться от их объемной концентрации.
Заряжение приповерхностной области полупроводника приводит к
появлению разности потенциалов между нею и объемом полупроводника и,
следовательно, к искривлению энергетических зон. При отрицательном
заряде на затворе, энергетические зоны изгибаются вверх, так как при
перемещении электрона из объема на поверхность его энергия
увеличивается. Если затвор заряжен положительно то зоны изгибаются
вниз.
Hа рисунке 1 показана зон-
ная структура n-полупроводни-
ка при отрицательном заряде на
затворе и приведены обозначе-
ния основных величин, характе-
ризующих поверхность; -раз-
ность потенциалов между повер-
хностью и объемом полупровод-
ника; — -изгиб зон у повер-
хности;… -се-
редина запрещенной зоны. Из
рисунка 2 видно, что в объеме
полупроводника расстояние от
дна зоны проводимости до уров-
ня Ферми меньше расстояния от
уровня Ферми до потолка вален-
тной зоны. Поэтому равновес-
ная концентрация электронов
больше концентрации дырок: как
и должно быть у n-полупровод-
ников. В поверхностном слое
объемного заряда происходит
искревление зон и расстояния
от дна зоны проводимости до
уровня Ферми по мере перемеще-
ния к поверхности непрерывно
увеличивается, а расстояние до
уровня Ферми до потолка вален-
тной зоны непрерывно
уменьшается. В сечении АА эти
расстояния становятся одинако-
выми (..................) и
полупроводник становится соб-
ственным: n=p=n. Правее сече-
ния АА…, в сед-
ствии чего p>n и полупровод-
ник становится полупроводни-
ком р-типа. У поверхности об-
разуется в этом случае повер-
хностный p-n переход.
Часто изгиб зон у поверх-
ности выражают в единицах kT
и обозначают Ys. Тогда… .
При формировании приповерхностной области полупроводника могут
встретиться три важных случая: обеднение, инверсия и обогащение этой
области носителями заряда. Эти случаи для полупроводников n- и p-типа
представлены на рис. 3.
Обедненная область появляется в том случае, когда заряд затвора
по знаку совпадает со знаком основных носителей тока (рис.3 а, г). Выз-
ванный таким зарядом изгиб зон приводит к увеличению расстояния от
уровня Ферми до дна зоны проводимости в полупроводнике n-типа и до
вершины валентной зоны в полупроводнике p-типа. Увеличение этого рас-
стояния сопровождается обеднением приповерхностной области основными
носителями. При высокой плотности заряда затвора, знак которого совпа-
дает со знаком заряда основных носителей, по мере приближения к повер-
хности расстояние от уровня Ферми до потолка валентной зоны в полупро-
воднике n-типа оказывается меньше расстояния до дна зоны проводимости.
Вследствии этого, концентрация неосновных носителей заряда /дырок/ у
поверхности полупроводника становится выше концентрации основных носи-
телей и тип проводимости этой области изменяется, хотя и электронов и
дырок здесь мало, почти как в собственном полупроводнике. У самой по-
верхности, однако, неосновных носителей может быть столько же или да-
же больше, чем основных в объеме полупроводника. Такие хорошо проводя-
щие слои у поверхности с типом проводимости, противоположным объемно-
му, называют инверсионными (рис.3 б, д). К инверсионному слою вглубь от
поверхности примыкает слой обеднения.
Если знак заряда затвора противоположен знаку заряда основных но-
сителей тока в полупроводнике, то под его влиянием происходит притяже-
ние к поверхности основных носителей и обогащение ими приповерхностно-
го слоя. Такие слои называются обогащенными (рис. 4 в, е).
При слабом обогащении или обеднении приповерхностной области по-
лупроводника ее размер определяется так называемой дебаевской длинной
экранирования:
где: .......-диэлектрическая проницаемость полупроводника; ......
-концентрация основных носителей тока в нем.
а протяжении слоя… напряженность электрического поля, по-
тенциал и изменение концентрации носителей тока относительно объема
полупроводника уменьшается в… раз по сравнению с их значениями на
поверхности.
В случае сильного обеднения толщину обедненного слоя можно рассчи-
тать по формуле для обедненного слоя в барьере Шотки, заменив в ней
… на… .
Наиболее сложно рассчитать структуру приповерхностного
слоя с инверсионной областью.
В интегральной электронике МДП-структуры широко используются для
создания транзисторов и на их основе различных интегральных микроcхем.
На рис. 4 схематически показана структура МДП-транзистора с изолиро-
ванным затвором. Транзистор состоит из кристалла кремния /например
n-типа/, у поверхности которого диффузией /или ионной имплантацией/ в
окна в оксиде формируются р-области, как показано на рис. 4 а. Одну из
этих областей называют истоком, другую — стоком. Сверху на них нано-
сят омические контакты. Промежуток между областями покрывают пленкой
металла, изолированной от поверхности кристалла слоем оксида. Этот
электрод транзистора называют затвором. Hа границе между р- и п-облас-
тями возникают два р-п-перехода — истоковый и стоковый, которые на ри-
сунке 4 а. показаны штриховкой.
Hа рис. 4 б приведена схема включения транзистора в цепь: к исто-
ку подсоединяют плюс, к стоку — минус источника напряжения…, к
затвору — минус источника…. Для простоты рассмотрения будем счи-
тать, что контактная разность потенциалов, заряд в оксиде и поверхнос-
тные состояния отсутствуют. Тогда свойства поверхностной области, в
отсутствие напряжения на затворе, ничем не отличаются от свойств по-
лупроводников в объеме. Сопротивление между стоком и истоком очень ве-
лико, так как стоковый р-п-переход оказывается под обратным смещением.
Подача на затвор отрицательного смещения сначала приводит к образова-
нию под затвором обедненной области, а при некотором напряжении .....
называемом пороговым, — к образованию инверсионной области, соединяю-
щей р-области истока и стока проводящим каналом. При напряжениях на
затворе выше… канал становится шире, а сопротивление сток-исток
— меньше. Рассматриваемая структура является, таким образом,
УПРАВЛЯЕМЫМ РЕЗИСТОРОМ.
Однако сопротивление канала определяется только напряжением на
затворе лишь при небольших напряжениях на стоке. С увеличением .....
носители из канала уходят в стоковую область, обедненный слой у стоко-
вого n-p-перехода расширяется и канал сужается (рис. 4, в). Зависи-
мость тока… от напряжения на стоке… становится нелинейной.
При сужении канала число свободных носителей тока под затвором
уменьшается по мере приближения к стоку. Чтобы ток в канале был одним
и тем же в любом его сечении, электрическое поле вдоль канала должно
быть, в таком случае, неоднородным, его напряженность должна расти по
мере приближения к стоку. Кроме того, возникновение градиента концен-
трации свободных носителей тока вдоль канала приводит к возникновению
диффузионной компоненты плотности тока.
При некотором напряжении на стоке… канал у стока перекры-
вается, при еще большем смещении канал укорачивается к истоку (рис.
4, г). Перекрытие канала однако не приводит к исчезновению тока стока,
поскольку в обедненном слое, перекрывшем канал, электрическое поле тя-
нет дырки вдоль поверхности. Когда носители тока из канала вследствии
диффузии попадают в эту область, они подхватываются полем и перебрасы-
ваются к стоку. Таким образом, по мере увеличения напряжения на стоке
чисто дрейфовый механизм движения носителей тока вдоль канала сменяет-
ся диффузионно-дрейфовым.
Механизм протекания тока в МДП-транзисторе при сомкнутом канале
имеет некоторые общие черты с протеканием тока в обратно-смещенном
n-p-переходе. Напомним, что в n-p-переходе неосновные носители тока
попадают в область пространственного заряда перехода вследствие диффу-
зии и затем подхватываются его полем.
Как показывают теория и эксперимент, после перекрытия канала ток
стока… практически насыщается (рис. 5). Значение тока насыще-
ния зависит от напряжения на затворе .....: чем выше…, тем шире
канал и тем больше ток насыщения (на рисунке ......................).
Это типично транзисторный эффект — напряжением на затворе (во входной
цепи) можно управлять током стока (током в выходной цепи). Характер-
ной особенностью МДП-транзисторов является то, что его входом служит
конденсатор, образованный металлическим затвором, изолированным от по-
лупроводника. Ток утечки затвора типичных МДП-транзисторов составляют
… А и могут быть уменьшены до… А. В рассматриваемом тран-
зисторе используется эффект поля, поэтому такие транзисторы называют-
ся ПОЛЕВЫМИ. В отличии от транзисторов типа p-n-p или n-p-n, в кото-
рых происходит инжекция неосновных носителей тока в базовую область, в
полевых транзисторах ток переносится только основными носителями. Поэ-
тому такие транзисторы называются также УНИПОЛЯРНЫМИ.
На границе раздела полупроводник — диэллектрик в запрещенной зо-
не полупроводника существуют энергетические состояния, называемые по-
верхностными или, точнее, состояниями граници раздела (рис. 6). Волно-
вые функции электронов в этих состояниях локализованы вблизи повер-
хности раздела в областях порядка постоянной решетки. Причина возник-
новения рассматриваемых состояний состоит в неидеальности граници раз-
дела полупроводник — диэллектрик (оксид). На реальных границах разде-
ла всегда имеется некоторое количество оборванных связей и нарушается
стехиометрия состава оксидной пленки диэллектрика. Плотность и харак-
тер состояний граници раздела существенно зависят от технологии созда-
ния диэллектрической пленки.
Наличие поверхностных состояний на границе раздела полупроводник
— диэллектрик отрицательно сказывается на параметрах МДП-транзистора,
так как часть заряда, наведенного под затвором в полупроводнике, зах-
ватывается на эти состояния. Успех в создании полевых транзисторов
рассматриваемого типа был достигнут после отработки технологии созда-
ния пленки… на поверхности кремния с малой плотностью состоя-
ний границы раздела… .
В самом оксиде кремния всегда существует положительный «встроен-
ный» заряд, природа которого до сих пор до конца не выяснена. Значе-
ние этого заряда зависит от технологии изготовления оксида и часто
оказывается настолько большим, что если в качестве подложки ис-
пользуется кремний р-типа проводимости, то у его поверхности образует-
ся инверсионный слой уже при нулевом смещении на затворе. Такие тран-
зисторы называются транзисторами со ВСТРОЕННЫМ КАНАЛОМ. Канал в них
сохраняется даже при подаче на затвор некоторого отрицательного смеще-
ния. В отличие от них в транзисторах, изготовленных на п-подложке, в
которой для образования инверсионного слоя требуется слишком большой
заряд оксида, канал возникает только при подаче на затвор напряжения
....., превышающего некоторое пороговое напряжение…. По знаку
это смещение на затворе должно быть отрицательным для транзисторов с
п-подложкой и положительным в случае р-подложки.
К униполярным транзисторам относят также транзисторы с управляю-
щим п-р-переходом, структуру которых схематически представлена на рис.
7, а. Канал проводимости в таких транзисторах представляет собой узкую
область в исходном полупроводнике, не занятую обедненным слоем п-р-пе-
рехода. Шириной этой области можно управлять, подавая на п-р-переход
обратное смещение. В зависимости от этого смещения меняется начальное
сопротивление сток-исток. Если при неизменном напряжении на р-п-пере-
ходе смещение сток-исток увеличивать, канал сужается к стоку и ток
стока растет с напряжением медленнее, чем при малых смещениях. При пе-
рекрытии канала (рис. 7, б) ток стока выходит на насыщение. Как меха-
низм протекания тока по каналу такого транзистора, так его выходные
характеристики весьма близки к характеристикам МДП-транзистора.
Входное сопротивление полевых транзисторов на низких частотах яв-
ляется чисто емкостным. Входная еикость… образуется затвором и
неперекрытой частью канала со стороны истока. Так как для заряда этой
емкости ток должен протекать через неперекрытую часть канала с сопро-
тивлением…, то собмтвенная постоянная времени транзистора рав-
на…. Это время, однако, очень мало, и в интегральных схе-
мах, применяемых, например, в цифровой вычислительной технике, дли-
тельность переходных процессов определяется не им, а паразитными ем-
костями схемы и входными емкостями других транзисторов, подключенных к
выходу данного. Вследствии этого при изготовлении таких схем стремят-
ся сделать входную емкость как можно меньшей за счет уменьшения длин-
ны канала и строгого совмещения границ затвора с границами стока и ис-
тока.
При больших напряжениях на стоке МДП-транзистора область объемно-
го заряда от стоковой области может распространиться настолько сильно,
что канал вообще исчезнет. Тогда к стоку устремятся носители из сильно
легированной истоковой области, точно так же как при «проколе» базы
биполярного транзистора (см «Твердотельная электроника» Г.И.Епифанов,
Ю.А.Мома #12.2 и рис.12.19).
При достаточно большом напряжении на стоке может также возник-
нуть обычный пробой обратносмещенного стокового р-п-перехода. Выход-
ные характеристики МДП-транзистора, включающие участки пробоя, пред-
ставлены на рис. 8.
__._______________________F_<____D:\EDITORS\WD\1.FRM-__єy▌;№;_4Ч6ж_h_R_MIч58√Cщь$kзя_ь-P:SЫ_*.MACC_
вэМГn■_т^P┬√M Мя___@∙J№цTч┴·DL▄■ыш├:┬ОE¤╥.__ф_бr АДЮяз╞# _
www.ronl.ru